晶圓薄化製程 溫度品質控管
固德科技報|晶圓薄化製程 溫度品質控管#OEE
#預知保養
#半導體
Posted On : 15 Jan. 2024
對於不同產品可能會有不同的生產目標溫度,而機台作業員在製作產品時,因為輸入錯誤的溫度值,可導致產品的失敗,需要卡控機制幫助避免人為錯誤。
3D封裝趨勢,晶圓薄化
隨著半導體封裝製程晶圓面積不斷微縮的物理極限, Filp chip、2.5D、3D IC、3D堆疊、3D Fabric等先進封裝的發展,提供了多個優勢,包括更高的性能、更小的封裝尺寸、更低的功耗、更高的集成度等。
雖然利用了不同的堆疊技術暫時解決了面積的問題,未來,晶圓薄化將會是另一個新的課題。需要在晶圓薄化的過程中減薄厚度,又必須兼顧晶圓的強度避免破片的風險,因此製程設備的穩定度當更加重要。
在薄化晶圓的製程中,晶圓表面覆蓋了一層保護膠帶,用來確保在後續製程中不受損傷。而剝離這層膠帶需要在特定的溫度條件下進行,以確保保護膠帶能夠容易且完整地從晶圓表面剝離。適當的溫度能夠使保護膠帶變得更加柔軟,容易剝離,同時又不會造成晶圓表面的損傷。因此,在操作過程中需要進行正確的溫度控制,溫度過高或過低都可能導致剝離過程變得困難。
#晶圓 #半導體 #封裝製程 #3D封裝
晶圓拋光超薄研磨
TSK PG 3000 RMX
是一種晶圓研磨和拋光設備,設計用於製造半導體晶圓。該設備系統採用一站式設計進行晶圓雙面粗磨、超精密減薄研磨、拋光和清潔工序。
來源:TOKYO SEIMITSU

製程發生人為錯誤
造成產品失敗
以下就PG 3000 RMX進行剝離附著在晶圓上的表面保護膠帶的溫度控管問題:

1.對於不同產品可能會有不同的生產目標溫度,而機台作業員在製作產品時,因為輸入錯誤的溫度值,可導致產品的失敗,需要卡控機制幫助避免人為錯誤。
2.由於溫度深切影響製程品質,在上升或降溫如果有超出時間,也可能導致產品失敗,需要能有告警機制提醒。
TCS 機台溫度控制系統
避免 OP 人員因為輸入失誤而造成產品損失
解:該設備具有內置的安全機制,包括安全外殼、安全窗簾、緊急停止輸入和緊急電源開關。藉由監測溫度加上PLC,當設備離開生產目標溫度時產生告警或於溫度未達時即時鎖住送料,並且制定溫控讀取機制避免操作人員輸入錯誤。
機台溫控系統是以OP掃碼,從IT端帶PPID,溫控系統自動帶入溫度值,傳輸至機台溫控器並且PLC鎖定溫度設定值,藉以避免OP人員因為輸入失誤而造成產品損失。



系統特點
掌握升降溫:最大升降溫時間設定,掌握升降溫性能。
趨勢圖表:可視化趨勢圖表,升降溫變化即時呈現。
自動鎖定:告警即刻鎖住送料,避免造成產品損失。
調配門檻:調配升降溫趨勢門檻值,優化產線流程。
溫控系統 安全機制
1.無法設定溫度表隨意更改參數 目標溫度 65度C 人為手操作調整40度C ,將自動回歸至目標溫度。無法自行從溫控器修改溫度設定值。

2. 未達到生產溫度區間,無法進行生產 未達設定的溫度目標區間,無法送料。到達目標溫度區間(+5,-5),可送料。
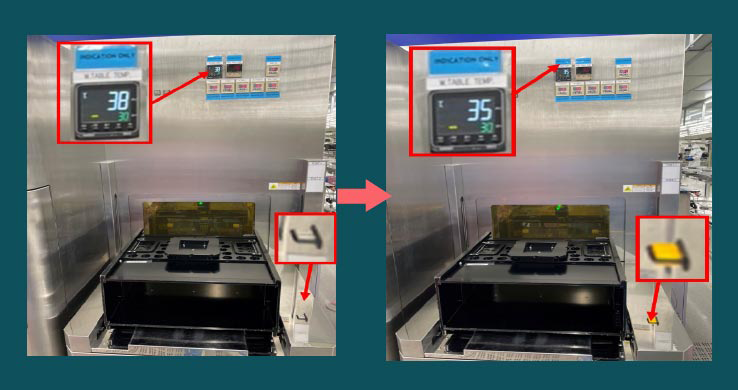
3. 不在溫度範圍,無法進行生產 當生產中,因加熱裝置、溫控裝置失效,離開生產目標溫度範圍,產生告警。

4.確認Log資訊或溫控程式資訊 當溫控蜂鳴器警報時,可確認Log資訊或溫控程式資訊。

安裝後效益
機台溫控改善後Benefit
1.避免OP人為操作失誤
2.PPID參數溫度核對後直接將溫度設定傳輸至機台
3.溫控器由PLC鎖定溫度設定值
4.最大升溫、最大降溫時間,可知道昇降溫性能狀況
5.具備升溫、降溫趨勢變化呈現
ALARM 告警並鎖住送料狀況
1.EAP斷線
2.PLC卡控硬體斷線
3.升溫/降溫 時間超時
4.PPID未找到溫度設定值
5.工作中溫度離開設定範圍
固德能為傳統封裝、先進封裝、CoWos、3D Fabric製程技術等,規劃合適的設備監測製程品質解決方案,歡迎與我們聯絡。






